
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
TaC ilə örtülmüş qrafit hissələrinin tək kristal sobalarda tətbiqi
2024-07-05
tətbiqiTaC ilə örtülmüş qrafit hissələriTək Kristal Ocaqlarında
HİSSƏ/1
Fiziki buxar nəqli (PVT) metodundan istifadə edərək SiC və AlN monokristallarının böyüməsində, tige, toxum saxlayan və bələdçi halqa kimi mühüm komponentlər mühüm rol oynayır. Şəkil 2 [1]-də göstərildiyi kimi, PVT prosesi zamanı toxum kristalı aşağı temperatur bölgəsində yerləşdirilir, SiC xammalı isə daha yüksək temperaturlara (2400 ℃-dən yuxarı) məruz qalır. Bu, xammalın parçalanmasına, SiXCy birləşmələrinin (ilk növbədə Si, SiC₂, Si₂C və s. daxil olmaqla) əmələ gəlməsinə gətirib çıxarır. Buxar fazasının materialı daha sonra yüksək temperatur bölgəsindən aşağı temperatur bölgəsindəki toxum kristalına daşınır, nəticədə toxum nüvələrinin formalaşması, kristal böyüməsi və monokristalların əmələ gəlməsi baş verir. Buna görə də, bu prosesdə istifadə olunan istilik sahəsi materialları, məsələn, pota, axın bələdçisi halqası və toxum kristal tutucusu, SiC xammalı və monokristalları çirkləndirmədən yüksək temperatur müqaviməti nümayiş etdirməlidir. Eynilə, AlN kristalının böyüməsində istifadə olunan qızdırıcı elementlər Al buxarına və N₂ korroziyasına tab gətirməli, eyni zamanda kristal hazırlama müddətini azaltmaq üçün yüksək evtektik temperatura (AlN ilə) malik olmalıdır.
Müşahidə edilmişdir ki, SiC [2-5] və AlN [2-3] hazırlamaq üçün TaC ilə örtülmüş qrafit termal sahə materiallarından istifadə minimal karbon (oksigen, azot) və digər çirkləri olan daha təmiz məhsullarla nəticələnir. Bu materiallar hər bölgədə daha az kənar qüsurları və daha aşağı müqavimət göstərir. Bundan əlavə, mikroməsamələrin və aşındırma çuxurlarının sıxlığı (KOH ilə aşındırıldıqdan sonra) əhəmiyyətli dərəcədə azalır və kristal keyfiyyətinin əhəmiyyətli dərəcədə yaxşılaşmasına səbəb olur. Bundan əlavə, TaC tigesi demək olar ki, sıfır çəki itkisini nümayiş etdirir, dağıdıcı görünüşünü saxlayır və təkrar emal edilə bilər (200 saata qədər istifadə müddəti ilə), beləliklə, monokristal hazırlamaq proseslərinin davamlılığını və səmərəliliyini artırır.
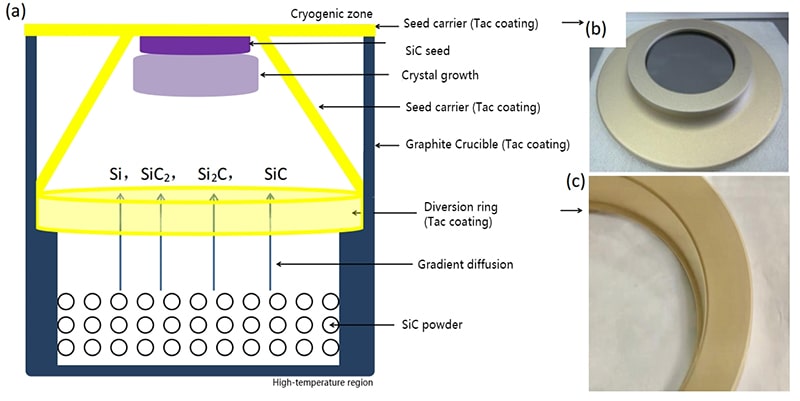
ŞEK. 2. (a) PVT üsulu ilə SiC monokristal külçə yetişdirən cihazın sxematik diaqramı
(b) Üst TaC örtüklü toxum mötərizəsi (SiC toxumu daxil olmaqla)
(c) TAC ilə örtülmüş qrafit bələdçi halqa
MOCVD GaN Epitaksial Layer Böyümə Qızdırıcısı
HİSSƏ/2
MOCVD (Metal-Üzvi Kimyəvi Buxar Depoziti) GaN artımı sahəsində, orqanometalik parçalanma reaksiyaları vasitəsilə nazik təbəqələrin buxar epitaksial böyüməsi üçün vacib bir texnika, qızdırıcı reaksiya kamerasında dəqiq temperatur nəzarəti və vahidliyə nail olmaqda mühüm rol oynayır. Şəkil 3 (a)-da göstərildiyi kimi, qızdırıcı MOCVD avadanlığının əsas komponenti hesab olunur. Onun substratı uzun müddət ərzində (təkrarlanan soyutma dövrləri daxil olmaqla) sürətlə və bərabər şəkildə qızdırmaq qabiliyyəti, yüksək temperaturlara (qaz korroziyasına qarşı müqavimət göstərmək) və filmin təmizliyini qorumaq qabiliyyəti filmin çökməsinin keyfiyyətinə, qalınlığın tutarlılığına və çip performansına birbaşa təsir göstərir.
MOCVD GaN artım sistemlərində qızdırıcıların performansını və təkrar emal səmərəliliyini artırmaq üçün TaC örtüklü qrafit qızdırıcıların tətbiqi uğurlu olmuşdur. pBN (pirolitik bor nitridi) örtüklərindən istifadə edən adi qızdırıcılardan fərqli olaraq, TaC qızdırıcılarından istifadə edərək yetişdirilən GaN epitaksial təbəqələri, demək olar ki, eyni kristal quruluşları, qalınlığın vahidliyini, daxili qüsurların əmələ gəlməsini, çirklərin dopinqini və çirklənmə səviyyələrini nümayiş etdirir. Bundan əlavə, TaC örtüyü aşağı müqavimət və aşağı səth emissiyası nümayiş etdirir, bu da qızdırıcının səmərəliliyini və vahidliyini artırır, bununla da enerji istehlakını və istilik itkisini azaldır. Proses parametrlərinə nəzarət etməklə, qızdırıcının radiasiya xüsusiyyətlərini daha da artırmaq və onun xidmət müddətini uzatmaq üçün örtüyün məsaməliliyini tənzimləmək olar [5]. Bu üstünlüklər TaC örtüklü qrafit qızdırıcıları MOCVD GaN artım sistemləri üçün əla seçim kimi müəyyən edir.
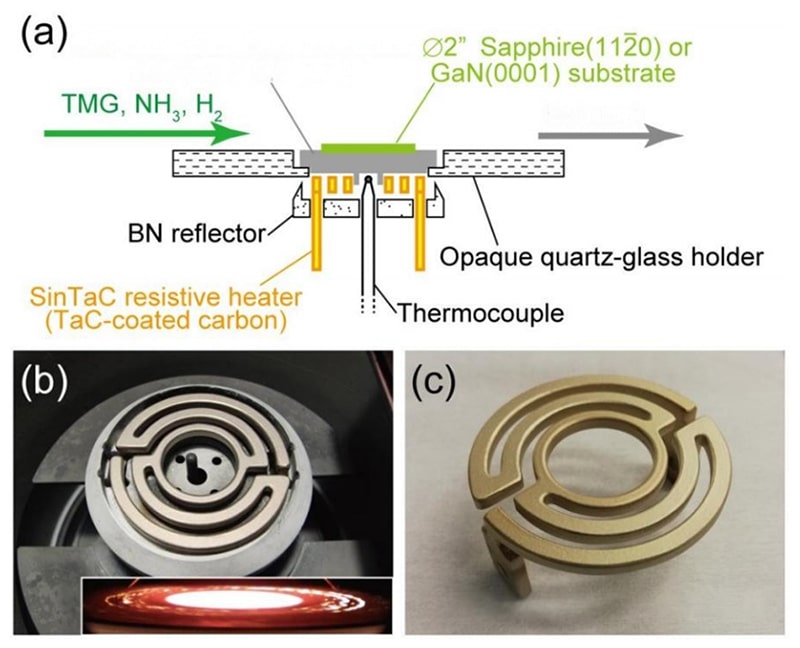
ŞEK. 3. (a) GaN epitaksial böyüməsi üçün MOCVD cihazının sxematik diaqramı
(b) MOCVD qurğusunda quraşdırılmış qəliblənmiş TAC ilə örtülmüş qrafit qızdırıcısı, baza və mötərizə istisna olmaqla (isitmə zamanı əsas və mötərizəni göstərən təsvir)
(c) 17 GaN epitaksial böyümədən sonra TAC ilə örtülmüş qrafit qızdırıcısı.
Epitaksiya üçün örtülmüş qəbuledici (Vaffer daşıyıcısı)
HİSSƏ/3
SiC, AlN və GaN kimi üçüncü dərəcəli yarımkeçirici vaflilərin hazırlanmasında istifadə edilən mühüm struktur komponenti olan vafli daşıyıcı epitaksial vafli böyümə proseslərində mühüm rol oynayır. Tipik olaraq qrafitdən hazırlanmış vafli daşıyıcı 1100 ilə 1600 °C arasında epitaksial temperatur diapazonunda texnoloji qazların korroziyasına müqavimət göstərmək üçün SiC ilə örtülmüşdür. Qoruyucu örtüyün korroziyaya davamlılığı vafli daşıyıcının xidmət müddətinə əhəmiyyətli dərəcədə təsir göstərir. Eksperimental nəticələr göstərdi ki, TaC yüksək temperaturlu ammonyak məruz qaldıqda SiC-dən təxminən 6 dəfə daha yavaş korroziya sürəti nümayiş etdirir. Yüksək temperaturlu hidrogen mühitlərində TaC-nin korroziya sürəti SiC-dən 10 dəfədən çox yavaşdır.
Eksperimental sübutlar göstərdi ki, TaC ilə örtülmüş qablar çirkləri daxil etmədən mavi işıqlı GaN MOCVD prosesində əla uyğunluq nümayiş etdirir. Məhdud proses tənzimləmələri ilə TaC daşıyıcılarından istifadə etməklə yetişdirilən LED-lər adi SiC daşıyıcılarından istifadə etməklə yetişdirilənlərlə müqayisə edilə bilən performans və vahidlik nümayiş etdirir. Nəticə etibarilə, TaC ilə örtülmüş vafli daşıyıcıların xidmət müddəti örtülməmiş və SiC örtüklü qrafit daşıyıcılarının xidmət müddətini üstələyir.
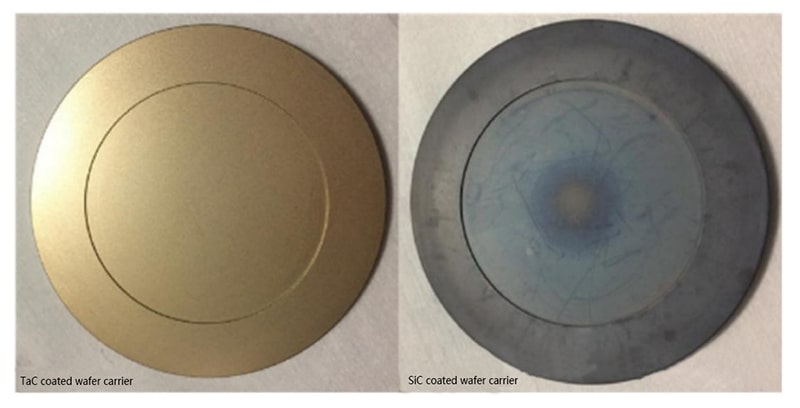
Şəkil. GaN epitaksial böyüdülmüş MOCVD cihazında (Veeco P75) istifadə edildikdən sonra vafli qab. Soldakı TaC ilə, sağdakı isə SiC ilə örtülmüşdür.
Ümumi hazırlıq üsuluTaC örtüklü qrafit hissələri
HİSSƏ/1
CVD (Kimyəvi Buxar Depoziti) üsulu:
900-2300 ℃ temperaturda tantal və karbon mənbələri kimi TaCl5 və CnHm, azaldıcı atmosfer kimi H₂, Ar₂as daşıyıcı qaz, reaksiya çökmə filmi kimi istifadə olunur. Hazırlanmış örtük yığcam, vahid və yüksək təmizliyə malikdir. Bununla belə, mürəkkəb proses, bahalı qiymət, çətin hava axınına nəzarət və aşağı çökmə səmərəliliyi kimi bəzi problemlər var.
HİSSƏ/2
Şlamın sinterləmə üsulu:
Tərkibində karbon mənbəyi, tantal mənbəyi, dispersant və bağlayıcı olan məhlul qrafit üzərinə örtülür və quruduqdan sonra yüksək temperaturda sinterlənir. Hazırlanmış örtük müntəzəm oriyentasiya olmadan böyüyür, aşağı qiymətə malikdir və geniş miqyaslı istehsal üçün uygundur. Böyük qrafit üzərində vahid və tam örtük əldə etmək, dəstək qüsurlarını aradan qaldırmaq və örtüyü bağlama gücünü artırmaq üçün araşdırılmalıdır.
HİSSƏ/3
Plazma çiləmə üsulu:
TaC tozu yüksək temperaturda plazma qövsü ilə əridilir, yüksək sürətli reaktivlə yüksək temperaturlu damcılara atomlaşdırılır və qrafit materialının səthinə səpilir. Qeyri-vakuum altında oksid təbəqəsi yaratmaq asandır və enerji sərfiyyatı böyükdür.
TaC ilə örtülmüş qrafit hissələrini həll etmək lazımdır
HİSSƏ/1
Bağlayıcı qüvvə:
TaC və karbon materialları arasında istilik genişlənmə əmsalı və digər fiziki xüsusiyyətlər fərqlidir, örtüyü bağlama gücü aşağıdır, çatlaqların, məsamələrin və termal gərginliyin qarşısını almaq çətindir və örtük çürük və çürük olan faktiki atmosferdə asanlıqla soyulur. təkrarlanan yüksəlmə və soyutma prosesi.
HİSSƏ/2
Saflıq:
TaC örtüyü yüksək temperatur şəraitində çirklərin və çirklənmənin qarşısını almaq üçün ultra yüksək təmizliyə malik olmalıdır və tam örtünün səthində və daxilində sərbəst karbon və daxili çirklərin effektiv məzmun standartları və xarakteristika standartları razılaşdırılmalıdır.
HİSSƏ/3
Sabitlik:
Yüksək temperatur müqaviməti və 2300℃-dən yuxarı kimyəvi atmosfer müqaviməti örtüyün dayanıqlığını yoxlamaq üçün ən vacib göstəricilərdir. Sancaqlar, çatlar, itkin künclər və tək oriyentasiyalı taxıl sərhədləri korroziyalı qazların qrafitə nüfuz etməsinə və nüfuz etməsinə səbəb olmaq üçün asandır, bu da örtük qorunmasının uğursuzluğuna səbəb olur.
HİSSƏ/4
Oksidləşmə müqaviməti:
TaC 500 ℃-dən yuxarı olduqda Ta2O5-ə qədər oksidləşməyə başlayır və oksidləşmə dərəcəsi temperaturun və oksigen konsentrasiyasının artması ilə kəskin şəkildə artır. Səthin oksidləşməsi dənələrin hüdudlarından və kiçik dənəciklərdən başlayır və tədricən sütunvari kristallar və qırıq kristallar əmələ gətirir, nəticədə çoxlu sayda boşluqlar və deşiklər əmələ gəlir və oksigen infiltrasiyası örtük soyulana qədər güclənir. Yaranan oksid təbəqəsi zəif istilik keçiriciliyinə və müxtəlif rənglərə malikdir.
HİSSƏ/5
Vahidlik və kobudluq:
Kaplama səthinin qeyri-bərabər paylanması yerli termal stress konsentrasiyasına səbəb ola bilər, çatlama və çatlama riskini artırır. Bundan əlavə, səthin pürüzlülüyü örtük və xarici mühit arasındakı qarşılıqlı əlaqəyə birbaşa təsir göstərir və çox yüksək pürüzlülük asanlıqla vafli və qeyri-bərabər istilik sahəsi ilə sürtünmənin artmasına səbəb olur.
HİSSƏ/6
Taxıl ölçüsü:
Vahid taxıl ölçüsü örtünün sabitliyinə kömək edir. Taxıl ölçüsü kiçikdirsə, bağ sıx deyil və oksidləşmək və korroziyaya məruz qalmaq asandır, nəticədə taxıl kənarında çoxlu çatlar və deşiklər əmələ gəlir, bu da örtünün qoruyucu xüsusiyyətlərini azaldır. Taxıl ölçüsü çox böyükdürsə, o, nisbətən kobuddur və istilik stresi altında örtük asanlıqla soyulur.
Nəticə və perspektiv
Ümumiyyətlə,TaC örtüklü qrafit hissələribazarda böyük tələbat və geniş tətbiq perspektivləri, cari varTaC örtüklü qrafit hissələriİstehsalın əsas istiqaməti CVD TaC komponentlərinə etibar etməkdir. Bununla belə, CVD TaC istehsal avadanlıqlarının yüksək qiyməti və məhdud çökmə səmərəliliyi səbəbindən ənənəvi SiC örtüklü qrafit materialları tamamilə dəyişdirilməyib. Sinterləmə üsulu xammalın dəyərini effektiv şəkildə azalda bilər və daha fərqli tətbiq ssenarilərinin ehtiyaclarını ödəmək üçün qrafit hissələrinin mürəkkəb formalarına uyğunlaşa bilər.



